N13 支援テーマ名:原子層制御結晶成長過程のその場観察(BL11XU)
- 研究内容 Ⅲ-V族半導体の分子線エピタキシー(MBE)成長
- 対象材料 GaAs、InAs、GaSb、InSb等
- 測定手法 表面X線回折法、X線反射率測定、逆格子マッピング等
利用研究例
MBE条件下でのGaAs(001)表面構造
Ⅲ-V族半導体では、Ⅲ族元素とV族元素の組成に自由度があることから、V族の圧力・基板温度などの成長条件に応じて、さまざまな表面超周期構造を示すことが知られています。これらの超周期構造に対応する原子配列を明らかにするのに、表面X線回折法は有力な手法です。左の図は、As圧5×10-7 Torr 、基板温度545℃で測定したGaAs(001)-2×4構造の例です。このようなX線回折パターンの測定から、実際の成長条件下における表面の原子配列およびその相転移過程を調べることができます。
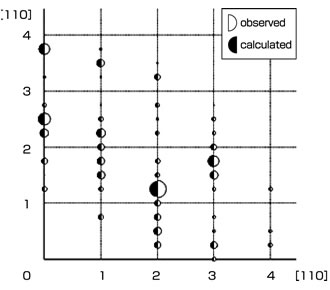
MBE成長過程のリアルタイム測定
MBE成長中のX線回折強度をリアルタイムで測定することによって、成長にともなう表面構造および表面形状の変化を動的に調べることができます。左の図は、GaAs(001)のホモエピタキシャル成長の際の110回折点の強度変化です。T=0min.で成長を開始し、T=17.5min.で成長を中止しています。成長中の強度振動や、成長中断後の強度回復のようすから、原子レベルでの成長過程が議論できます。X線の場合、電子線回折のような多重散乱の効果が無視できるので、解析が容易になるという利点があります。
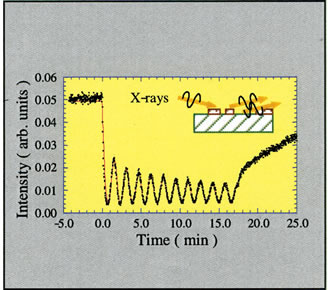
主な測定装置
- 表面X線回折計…水平・垂直あわせて4軸の自由度をもち、さまざまな測定モードに対応しています。
表面垂直方向への逆格子ロッドに沿った強度分布(CTR散乱)も測定可能です。 - X線CCDカメラ…逆格子マッピングの迅速な測定ができます。
- 分子線エピタキシー装置…Ga、Al、In、As、Sbの分子線源が利用できます。(他の分子線源の場合はご相談ください)

